热壁MOCVD有助于GaN-on-AlN HEMT
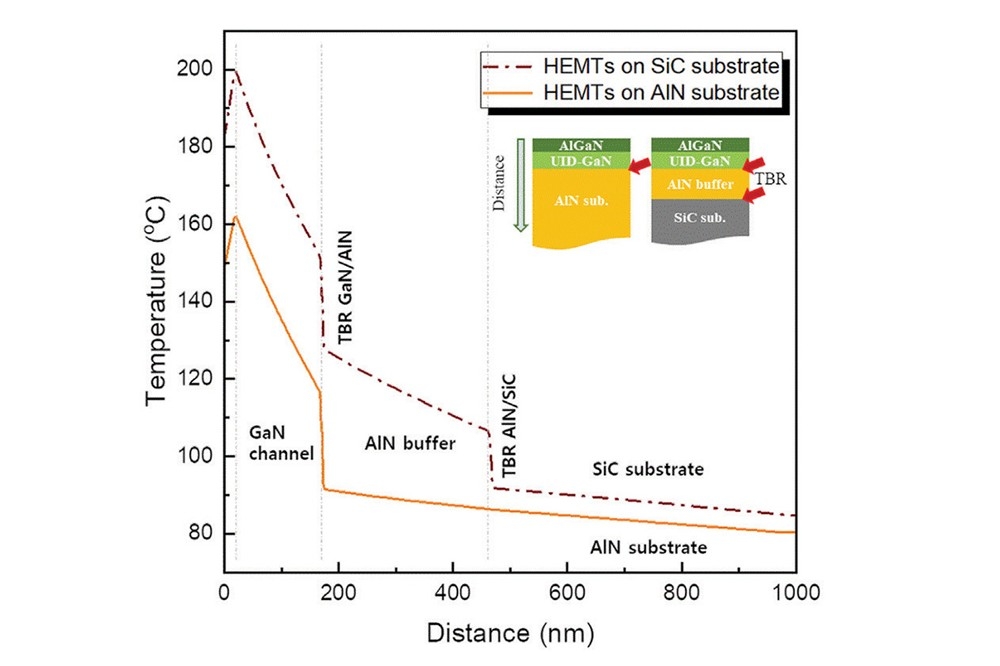
由林雪平大学领衔的国际合作团队正在突破氮化铝衬底上氮化镓高电子迁移率晶体管(GaN-on-AlN HEMT)的性能极限。这项创新性研究采用热壁金属有机化学气相沉积(MOCVD)技术,成功制备出兼具高载流子密度与创纪录二维电子气(2DEG)迁移率的超薄沟道器件。
"这就像在冰面上编织丝绸,"项目负责人万尼亚·达拉克切娃教授形象地描述道,"在AlN衬底上生长低缺陷密度、结构完美的超薄GaN层,其难度堪比在湍流中保持平衡。"这位来自林雪平大学与隆德大学的资深学者指出,团队突破的关键在于其独特的Aixtron热壁MOCVD反应器。"这台设备就像一位精准的调温师,"她解释道,"通过消除温度梯度波动,实现了气相化学反应的完美掌控。"
虽然AlN衬底常因其"贵族身份"——高昂成本、有限尺寸和稀缺性而令人却步,但达拉克切娃教授看到了曙光:"随着深紫外LED等新兴应用的蓬勃发展,犹如春笋般涌现的新型衬底制备技术正在改写成本方程式。"她特别提及XTAL.Works公司的创新性物理气相传输(PVT)技术,称其为"宽带隙半导体领域的破冰船"。
研究团队需要跨越的"技术鸿沟"源于AlN与GaN之间2.4%的晶格失配——这就像试图让两个不同步的舞者完美配合。当GaN生长厚度超过临界值时,晶格应变会通过三维岛状生长或位错等机制释放。更棘手的是,AlN衬底的高表面能如同粘稠的蜜糖,会束缚镓原子的扩散能力,促使其聚集成岛。
然而,瑞典团队凭借Aixtron VP508GR反应器这一"高温熔炉",成功在微型AlN和4H-SiC衬底上培育出优质的GaN外延层。经过1340℃氢气氛下的精细"退火浴",研究者在1250℃先培育300nm AlN种子层,再于1080℃"浇灌"GaN层。扫描电镜这位"微观世界的摄影师"揭示:标准工艺下1mm厚GaN层展现出镜面般的光洁度,但在追求超薄沟道时却遭遇"岛屿星罗"的困境。通过提高镓前驱体流速和降低生长压力至50毫巴,终于实现了"大陆架合并"的完美覆盖。
有趣的是,AlN衬底上的GaN覆盖度竟超越了传统SiC衬底。达拉克切娃教授将其比作"更温暖的舞池"——更高的面外热导率提升了表面温度,使得镓原子能够跳着更流畅的"扩散之舞"。基于此,团队制备出迁移率高达1910cm²/V·s(SiC衬底)和1805cm²/V·s(AlN衬底)的HEMT器件,这组数字犹如半导体界的"新海拔纪录"。
热管理测试显示,AlN衬底器件的运行温度较SiC衬底版本降低约20%,这要归功于TCAD模拟揭示的优异热边界传导性能。"就像给芯片装上了液态金属散热器,"达拉克切娃教授如此形容。目前,该团队正对两种衬底上的器件进行"终极考验",性能与热特性的全面评估将为这项突破性技术指明产业化方向。
永霖光电-UVSIS-UVLED紫外线应用专家-独家发布
