HBM4量产就绪|2026年AI与数据中心新标配

前言扩展阅读:从HBM4到HBM8:下一代HBM存储革命
近日,SK海力士宣布成功开发面向AI的超高性能存储器新产品HBM4,并在全球首次构建了量产体系。这一消息迅速引发行业震动,当日SK海力士股价盘中一度上涨超5%。
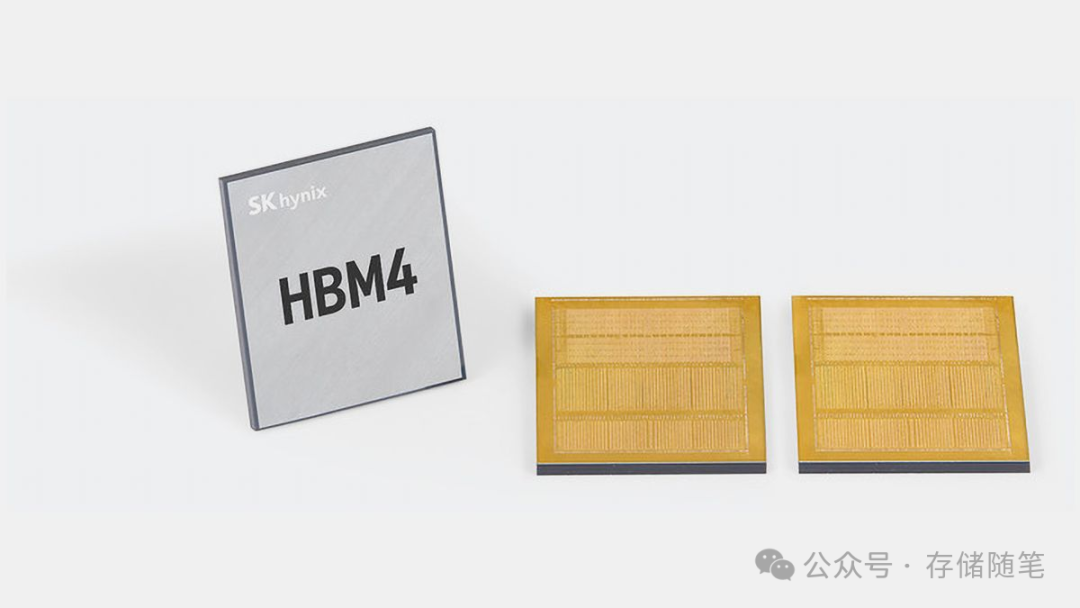
HBM4作为高带宽存储器技术的最新一代产品,采用了2048条数据传输通道(I/O),较前一代HBM3E的1024条翻倍。实现了带宽扩大一倍的同时,能效提升40%以上,运行速度高达10Gbps,大幅超越JEDEC标准规定的8Gbps。
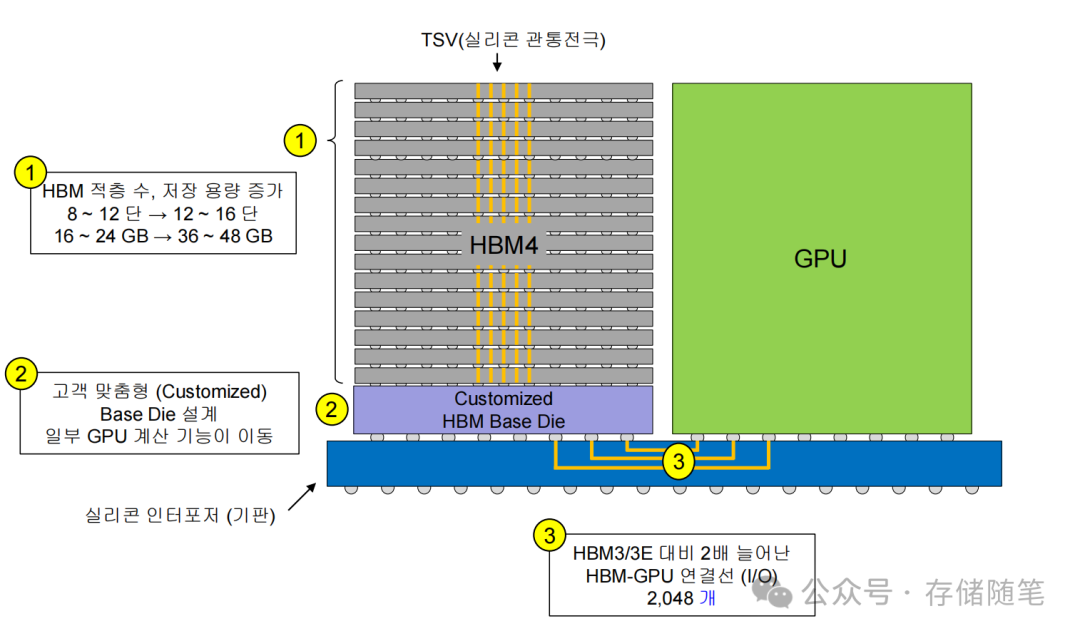
自2015年HBM技术问世以来,这是首次将HBM接口宽度翻倍。2048位接口让HBM4实现了带宽的倍增,这也是HBM技术发展史上最重大的一次接口扩容。
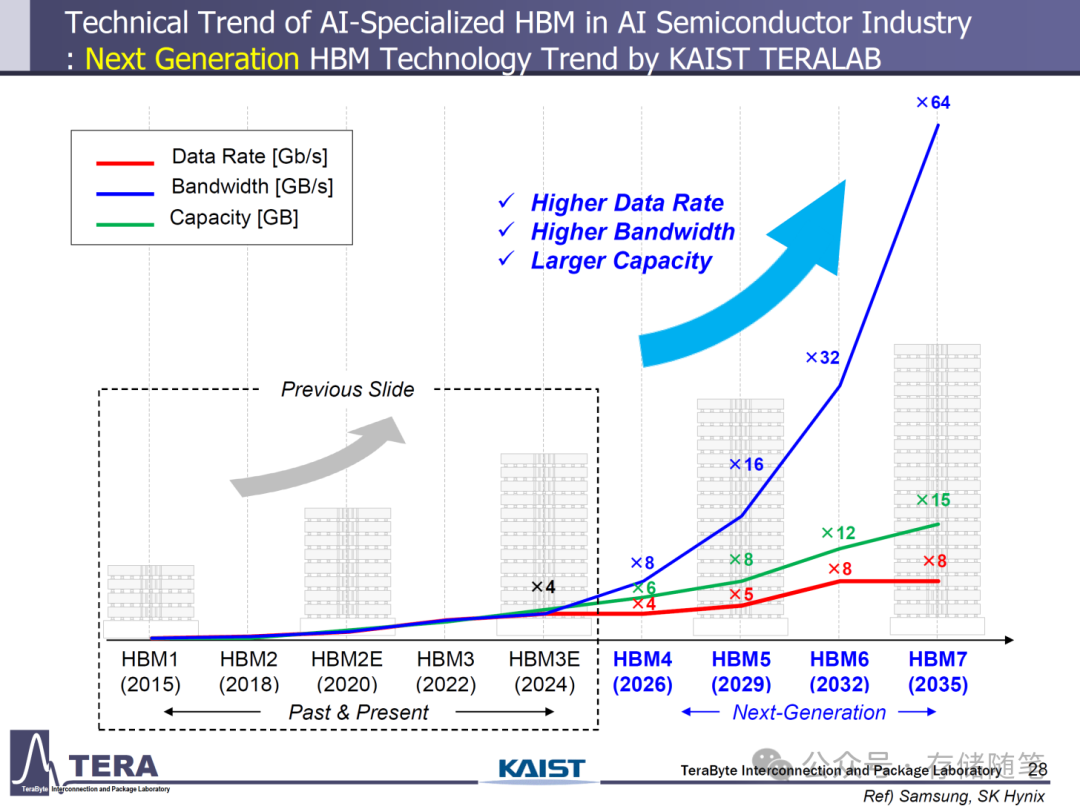
SK海力士的HBM4实现了高达10Gbps以上的运行速度,这大幅超越JEDEC标准规定的8Gbps。相比行业标准提升了25%,显示出SK海力士在技术上的领先地位。
在亚微米级互连尺度下,信号传输速度每提升1 GT/s都意味着巨大的工程挑战:SK海力士采用第五代10nm级DRAM工艺,通过缩短晶体管沟道长度和优化金属互联层,将信号延迟控制在50ps以内。对比来看,美光目前采样的HBM4产品速率为9.2 GT/s,虽落后于SK海力士,但仍高于JEDEC标准,显示出行业对超规格性能的普遍追求。
HBM4的性能跃升绝非仅靠规格升级,更依赖于先进制造工艺与封装技术的协同突破。SK海力士在HBM4上延续并升级了其独家的Advanced MR-MUF(Mass Reflow Molded Underfill)封装工艺,这项技术被证明是实现高堆叠层数与高可靠性的关键。
MR-MUF工艺指在堆叠半导体芯片后,为了保护芯片间的电路,在其中填充液体保护材料,使其固化。与每堆一个芯片就铺设薄膜型材料的方式相比,该技术提高了效率和散热效果。MR-MUF技术较现有技术减少了芯片堆叠时所施加的压力,提高了芯片的翘曲控制力(Warpage Control),这是确保HBM稳定量产的关键。

MR-MUF工艺的核心优势在于热管理与结构稳定性的双重优化。与三星、美光采用的TC-NCF(热压非导电胶膜)技术不同,MR-MUF采用"先堆叠后填充"的制程:在完成所有DRAM层的临时连接后,通过一次回流焊完成永久键合,随后向芯片间隙注入环氧模塑料(EMC)。这种工艺使热导率达到TC-NCF的两倍,有效解决了12层以上堆叠的散热难题。
