AEC-Q100 stress实验详解#3——HTSL(高温储存寿命测试)
3. HTSL(高温储存寿命测试)
- 实验目的——HTSL(High Temperature Storage Life,高温储存寿命测试)主要用于评估集成电路在高温环境下的长期稳定性,核心目标包括:
-
验证材料热稳定性:检测芯片封装材料(如塑封树脂、金属键合线)在高温下的老化、氧化或退化风险。
-
暴露潜在失效:通过高温加速模拟芯片在非工作状态下(如仓储或长期停放)的性能退化,识别电参数漂移、界面分层等失效。
-
- 实验方法——HTSL需严格遵循JEDEC JESD22-A103标准,关键步骤如下:
-
温度设置:
-
Grade0:175℃ Ta 1000小时或者150℃ Ta 2000小时
-
Grade1:150℃ Ta 1000小时或者175℃ Ta 500小时
-
Grade2&3:125℃ Ta 1000小时或者150℃ Ta 500小时
-
-
样品要求:
-
数量:45颗芯片 × 1个生产批次
-
状态:器件处于非工作状态(无偏置电压),仅暴露于高温环境
-
-
-
失效机制:
-
IMC问题:
高温环境下,金属原子(如Au、Cu、Al)扩散加速,在键合界面形成IMC层。IMC本身具有硬而脆的特性,其厚度随温度和时间呈抛物线增长(δ=k√t)。当IMC过厚时,其脆性会引发内部微裂纹,导致键合点机械强度下降甚至断裂。
典型案例:Au-Al键合系统中,IMC生长速度最快(如AuAl₂、Au₄Al等),高温储存1000小时后可能出现Kirkendall空洞(因Au原子扩散速率远高于Al原子,导致金球内部形成孔隙)
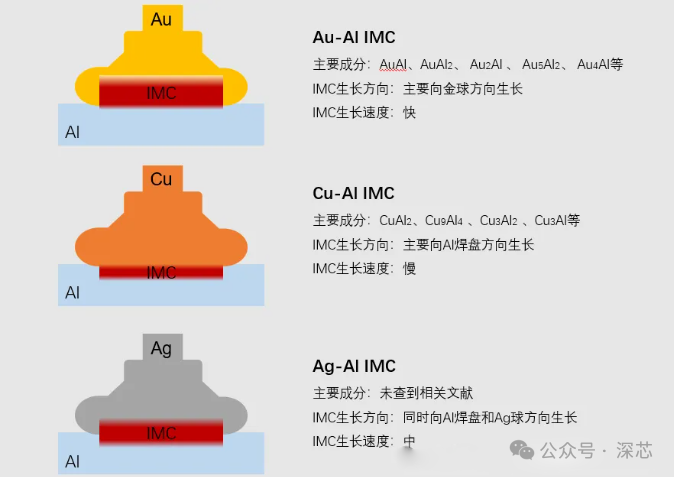
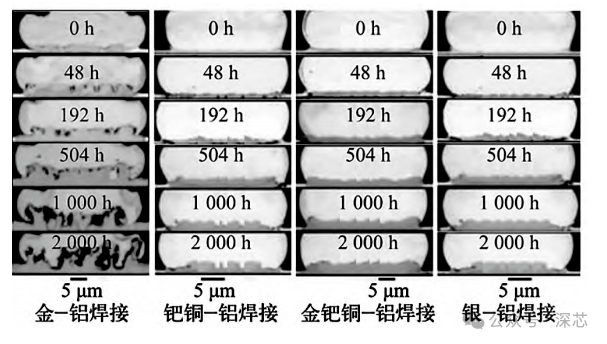
-
材料热退化
-
塑封料老化:高温导致树脂Tg(玻璃化转变温度)降低,引发封装开裂或分层(如芯片与塑封料界面分离)
-
金属氧化:键合线(如铝线)或焊盘表面氧化,导致接触电阻升高或开路失效。
-
-
界面失效
-
分层(Delamination):高温下不同材料CTE(热膨胀系数)不匹配,产生应力累积,导致界面分离(常见于芯片/塑封料或金属/钝化层界面)
-
焊料蠕变:高温加速焊料(如SnAgCu)晶界迁移,引发焊点空洞或裂纹。
-
-
电参数漂移
-
漏电流增加:高温促使栅氧缺陷生成或杂质扩散,导致MOSFET阈值电压漂移(如NBTI效应)
-
绝缘性能下降:高温湿气残留可能引发金属离子迁移,造成绝缘电阻降低。
-
-
