封装相关学习
硅片上切割出来的芯片没法用,一方面是没有和外部链接的引脚,另一方面是太脆弱了容易坏
封装厂拿到的晶圆的厚度还是比较厚的,封装厂需要进行研磨

接着需要切割,得到芯片裸片


切割出来的芯片会附着在胶带上,洁美是不是就做这个的?圆孔是用来定位的,胶带这里应该会有检测需求
然后需要用顶针把芯片顶出来,然后用真空吸拾器把芯片吸起来

接下来是装片,装片就是用胶等东西把它放在pcb板上

接下来就是把芯片留有的触点和pcb板进行缝合

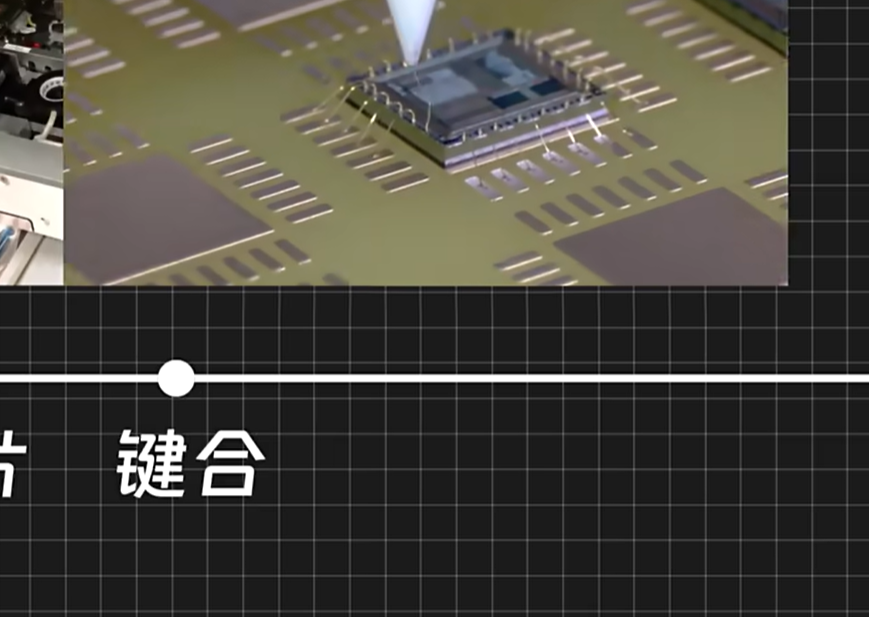
接下来就是塑封,就是把焊接好的给他装个外壳保护起来


这几个步骤叫DP、DA、WB、SBM、SS

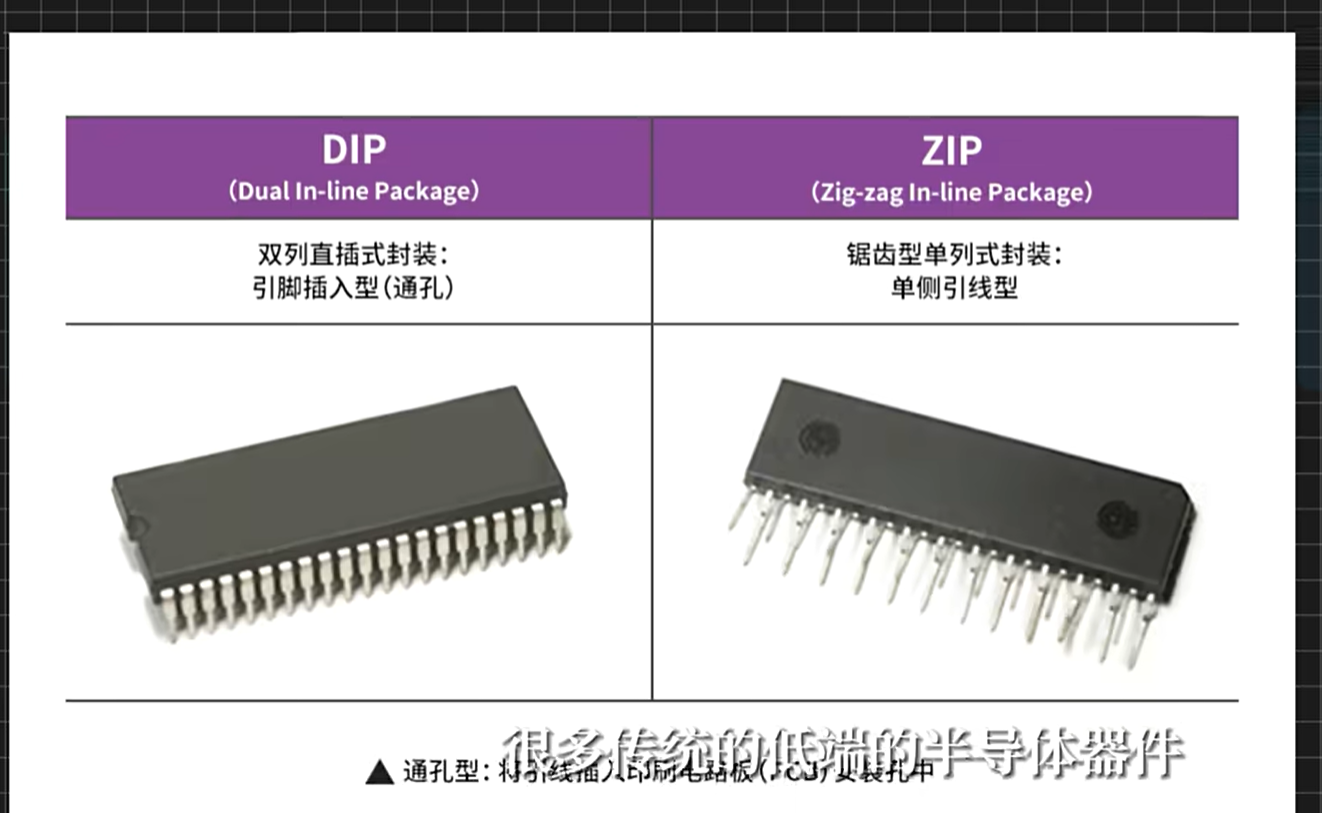
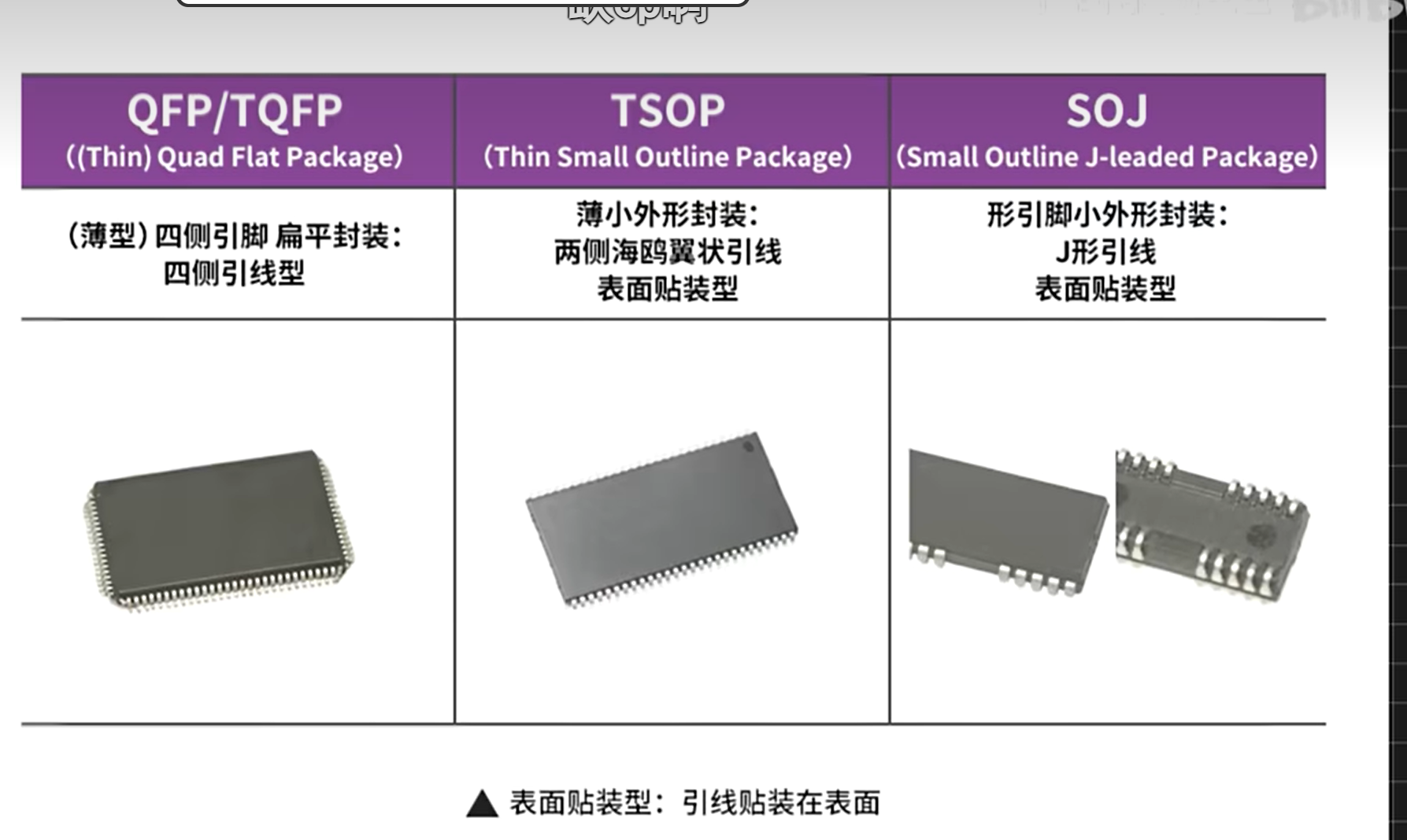
传统的上述封装会存在一些问题

引线长导致传输时间长,且引线的高阻抗容易导致信号的失真


以下来自网友对于该科普视频的评论:
一看就知道是个外行自己脑补得到的观念,然后推导出让人笑到喷饭的结论。先讲结论:强如台积电也是耗费十年的时间才终于实现2.5/3D封装,你却以为华为画几张图就能追上来?利用先进封装封装chiplet所制造出晶片成本非常高,几乎与SoC差不多,因此会采用chiplet其实是为了能够持续推升晶片性能,因为单一颗SoC的面积是有上限,如果制程技术难以再推升,将导致单一颗Soc所能容纳的晶体管数量是有上限,性能也就出现瓶颈,而不是up主以为的“用封装技术来补制程工艺不足”,换言之,中国连5nm,3nm制程都追不上,更是不可能利用封装追上什么。如果仔细看AMD最近产品布局就会发现,chiplet只用在高阶产品,中低阶产品仍然采用Soc。另外up主还闹笑话提到“Chiplet 制程工艺成熟,良率高”,就以AMD 7900x 所采用的是5nm/6nm的Chiplet,5nm/6nm会是所谓制程工艺成熟?笑死,Chiplet良率高是因为同样采用5nm工艺下,由于仅需切割成相对很小的晶片,就能避开有瑕疵的关系。就像从空中随机落下有毒液体,身躯越大的动物被滴中的机率就越高
