激光隐形切割(Stealth Dicing)技术
前言与目录
隐形切割(Stealth Dicing)技术概述
隐形切割是一种创新的激光切割技术,通过激光实现高精度切割。其核心优势包括完全干燥工艺、无截口损失、无切屑生成以及高弯曲强度。
技术特点
-
完全干燥工艺:无需冷却液或其他介质,减少污染风险。
-
无截口损失:切割过程中材料损耗极低,提升利用率。
-
无切屑:避免碎屑对精密器件的影响,提高成品率。
-
高弯曲强度:切割后的材料结构更稳定,适用于高应力环境。
适用领域
该技术可广泛应用于MEMS器件、存储器件等精密电子元件,满足高精度、高可靠性的加工需求。
隐切原理: 隐形切割技术可将能够穿透材料的波长的激光光束聚焦,在内部聚焦并形成晶圆破裂的起点(改性层:隐形切割层,以下称为“SD 层”),然后向晶圆施加外部应力,将其分离。
该过程主要由两部分组成,一般被称为激光改制过程与晶圆扩展分离过程;
一、隐切激光改制过程:
-
激光光束聚焦在晶圆内部,形成 SD 层以分离晶圆。
-
裂纹也从 SD 层形成,而 SD 层在内部朝向晶圆的顶部和底部表面形成,这些裂纹通过激光光束扫描沿着计划的切割线连接。
-
此外,为了切割 MEMS 器件等厚晶圆,在厚度方向上形成多个 SD 层,然后连接裂纹。
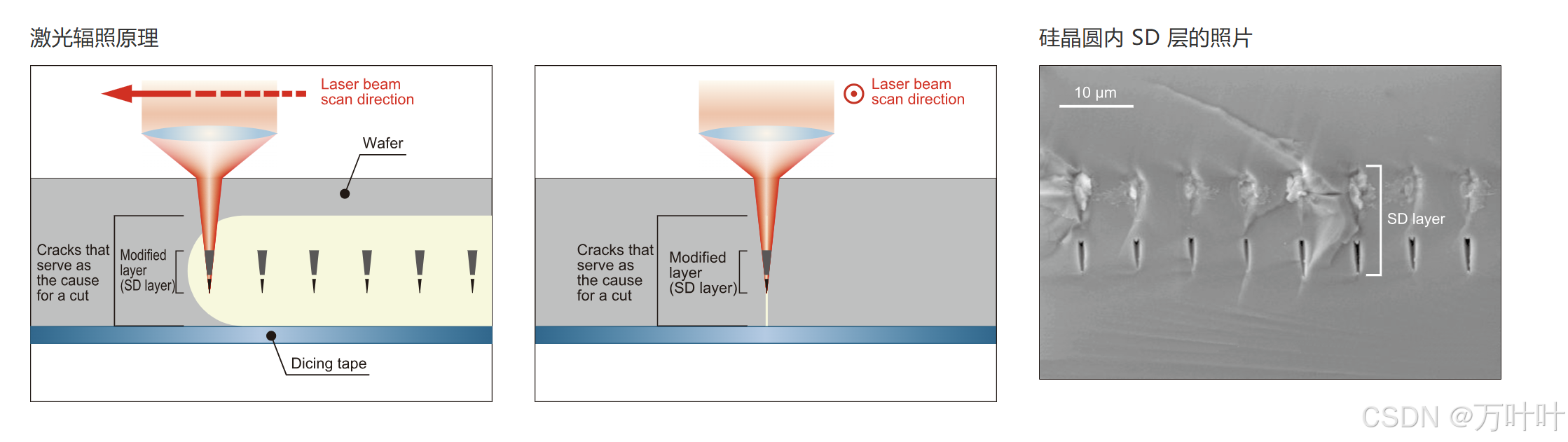
根据SD层行为可以分为

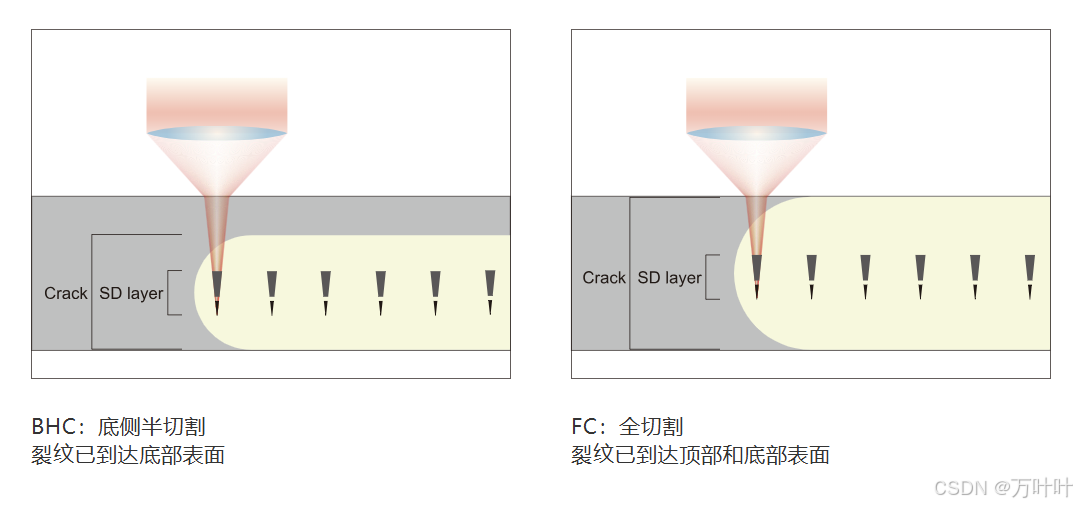
二、晶圆扩展分离过程:
-
通过胶带膨胀等行为在周边方向上拉紧胶带,对已形成 SD 层的晶圆施加外力。这会对晶圆的内部裂纹状态施加拉应力,并使裂纹延伸到顶部和底部表面,从而分离晶片。
-
由于晶圆分离是通过延伸裂纹进行的,因此没有应力施加在器件上。此外,由于基本上没有截口损失,这会提高芯片成品率。
一般这种可能伴随劈裂或研磨;之后再通过扩膜将晶圆分离;
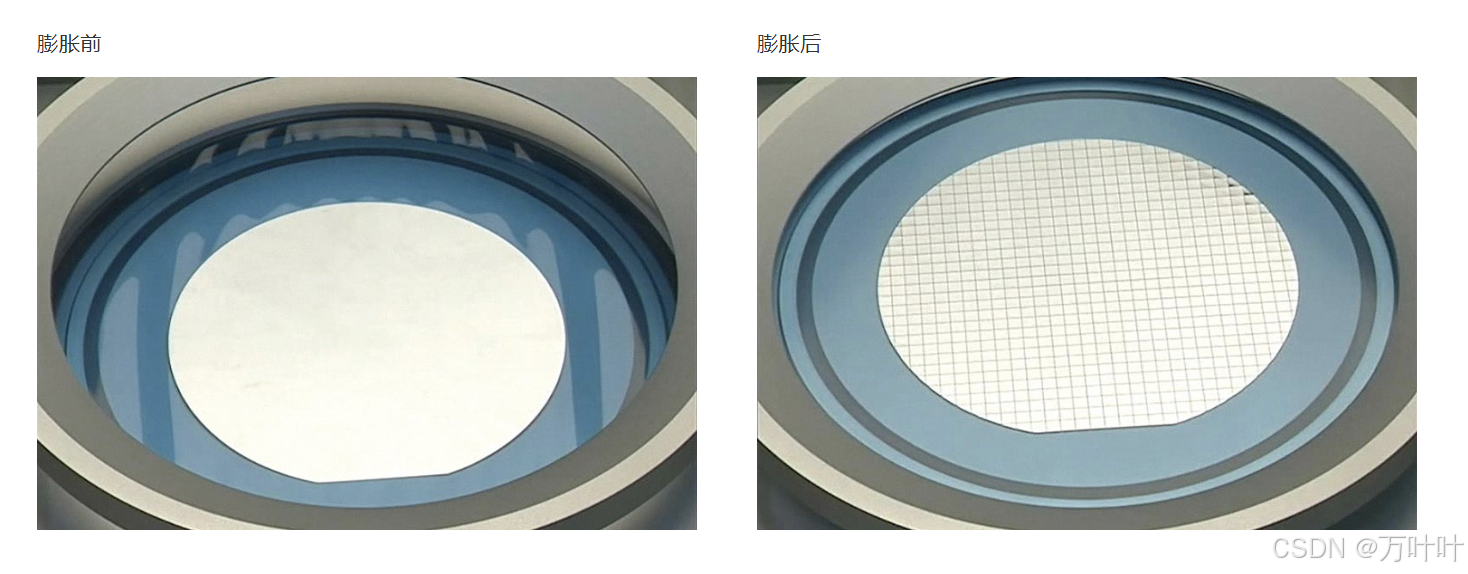
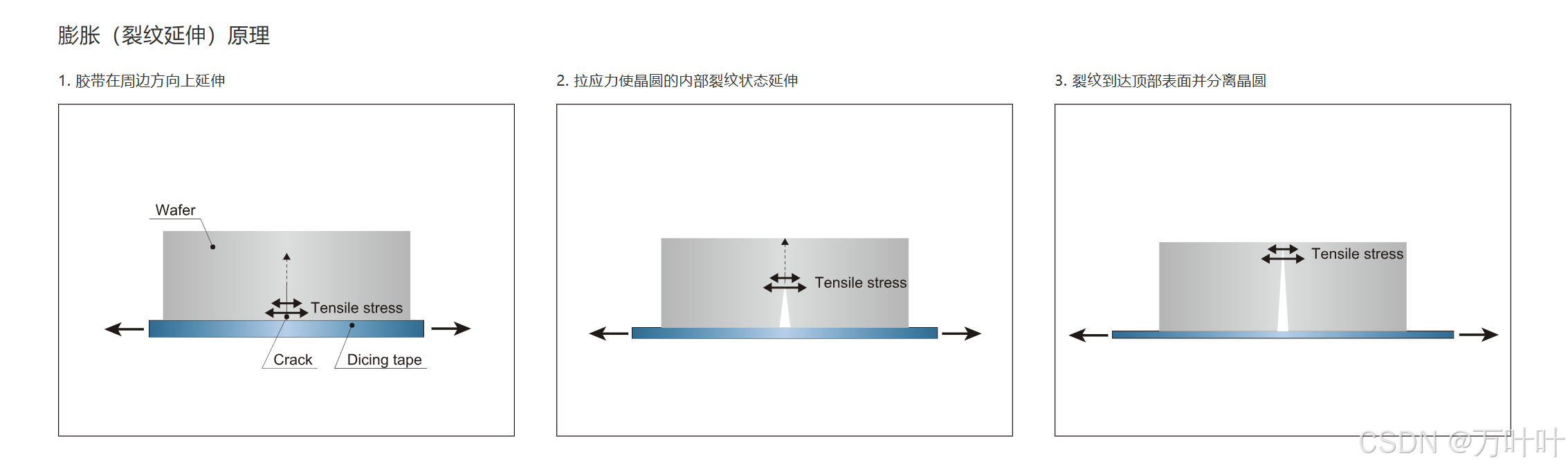
隐形切割技术的特点
隐形切割技术通过非接触式激光处理,避免了传统切割方法带来的物理或热应力问题。其核心优势在于无需机械接触或高温烧蚀,直接从内部实现材料分离,从而减少污染、应力损伤和工艺复杂度。
与传统技术的区别
刀片切割的局限性
金刚石砂轮高速旋转切割晶圆时,机械接触会引入振动和冷却水残留,导致应力负荷和再污染。切屑堆积可能削弱晶圆结构强度,而分散的颗粒物会引发脆性断裂,需额外增加保护膜工序。此外,刀片切割受限于成品率和处理速度。
烧蚀切割的局限性
激光烧蚀通过高温蚀刻凹槽实现切割,但热影响区(HAZ)会导致材料强度劣化。同样存在分散物质污染问题,需保护膜工序辅助。激光烧蚀的成品率和处理速度也面临瓶颈。
隐形切割的改进点
隐形切割无需物理接触或高温烧蚀,通过激光内部聚焦直接分离晶圆,避免了应力、热损伤和污染。省去保护膜工序,提升成品率,同时处理速度更快。
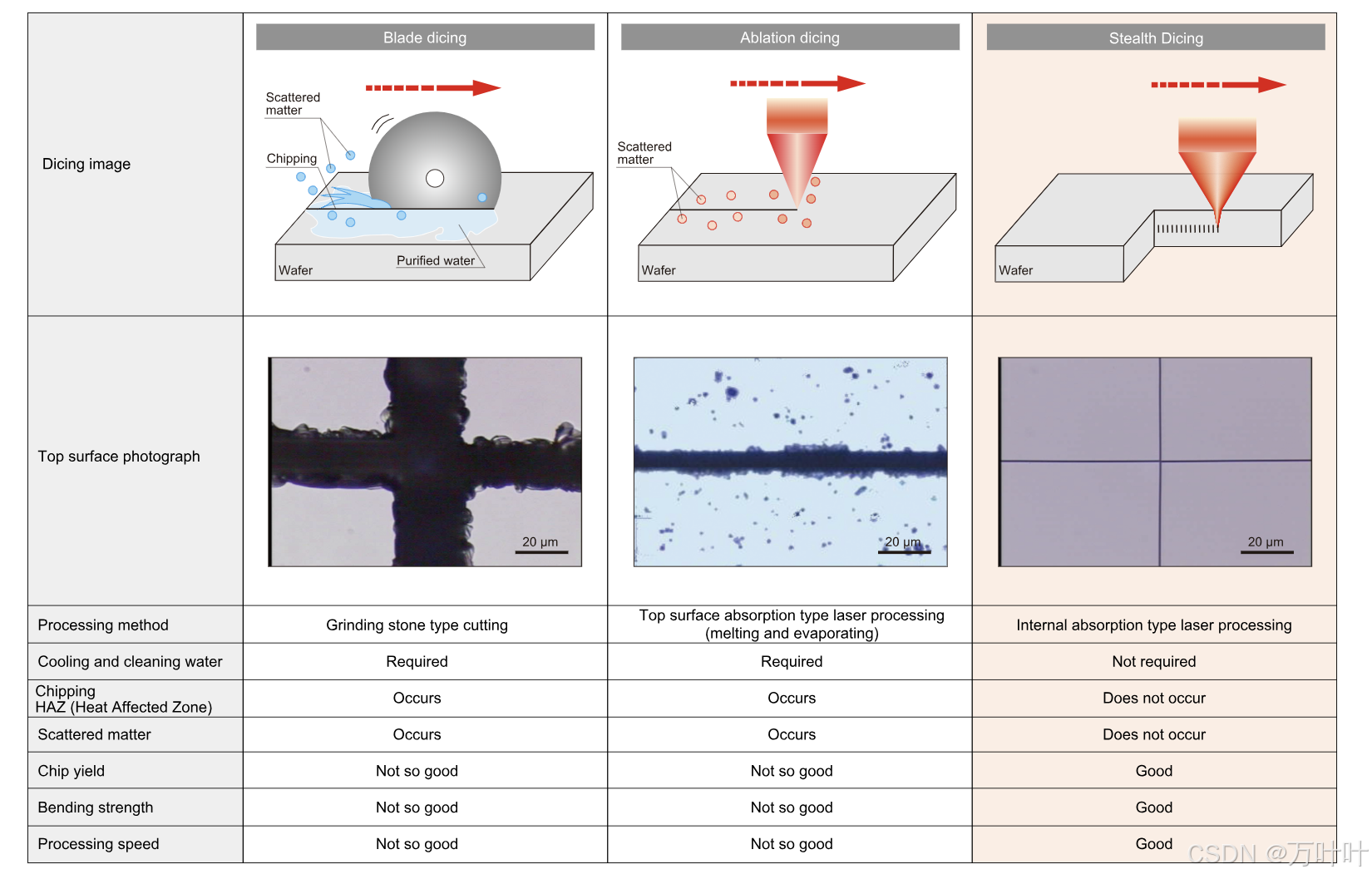
--

本篇文章为个人学习笔记,供学习和复习使用。未经允许不得转载或用于商业用途。
